-
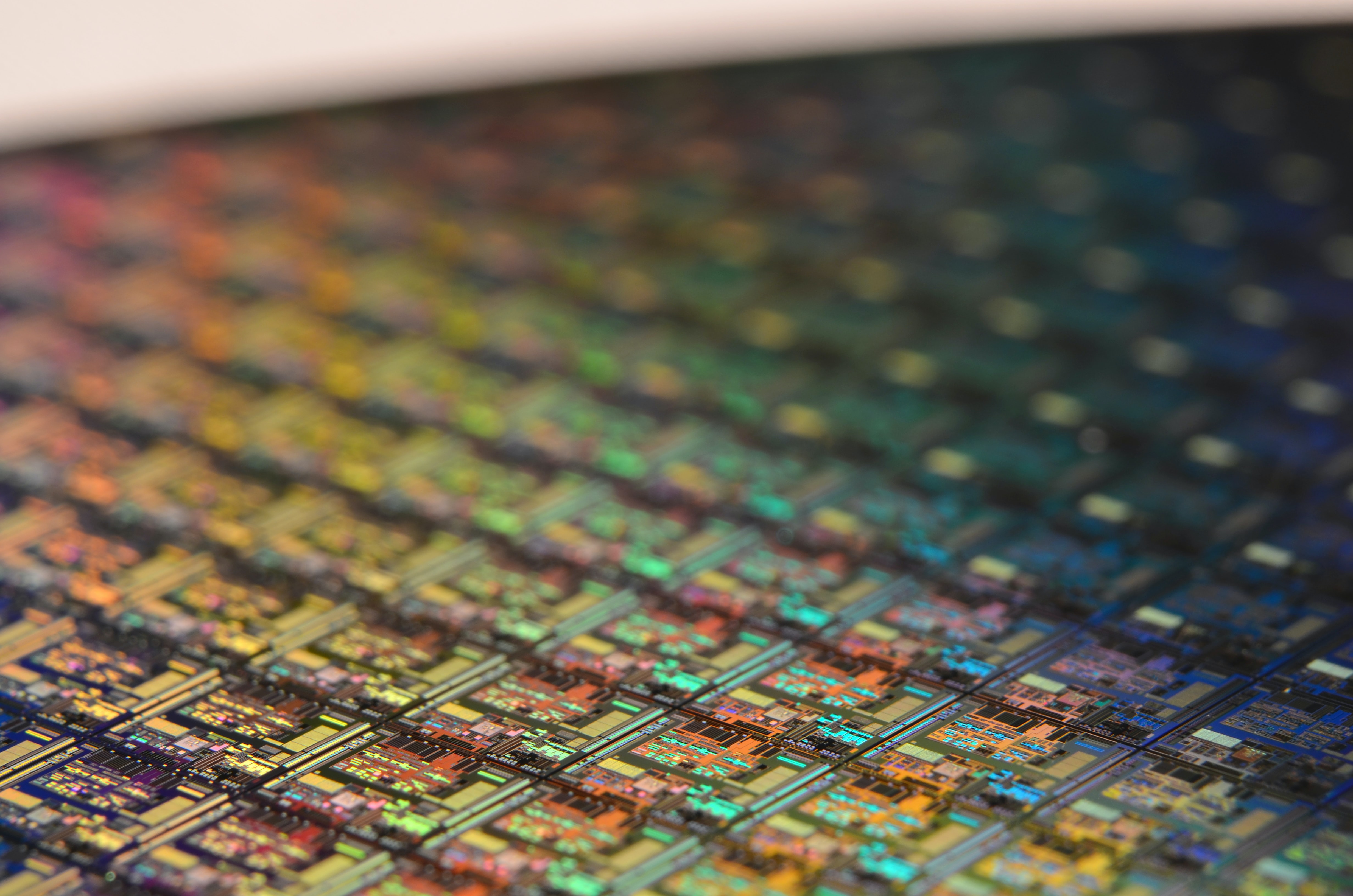
华体会hth登录-砺算科技首批G100芯片已完成主要功能测试
5月26日,东芯股份发布了关于对外投资的进展公告,称公司已完成向砺算科技增资2亿元,认购其新增注册资本500万元。此外,东芯股份表示已于2025年5月26日收到上海砺算科技出具的《关于G100芯片进展的告知函》。其中提到,2025年5月24日,上海砺算科技收到了首批封装完成的G100芯片,即刻启动功
2025-10-17 -
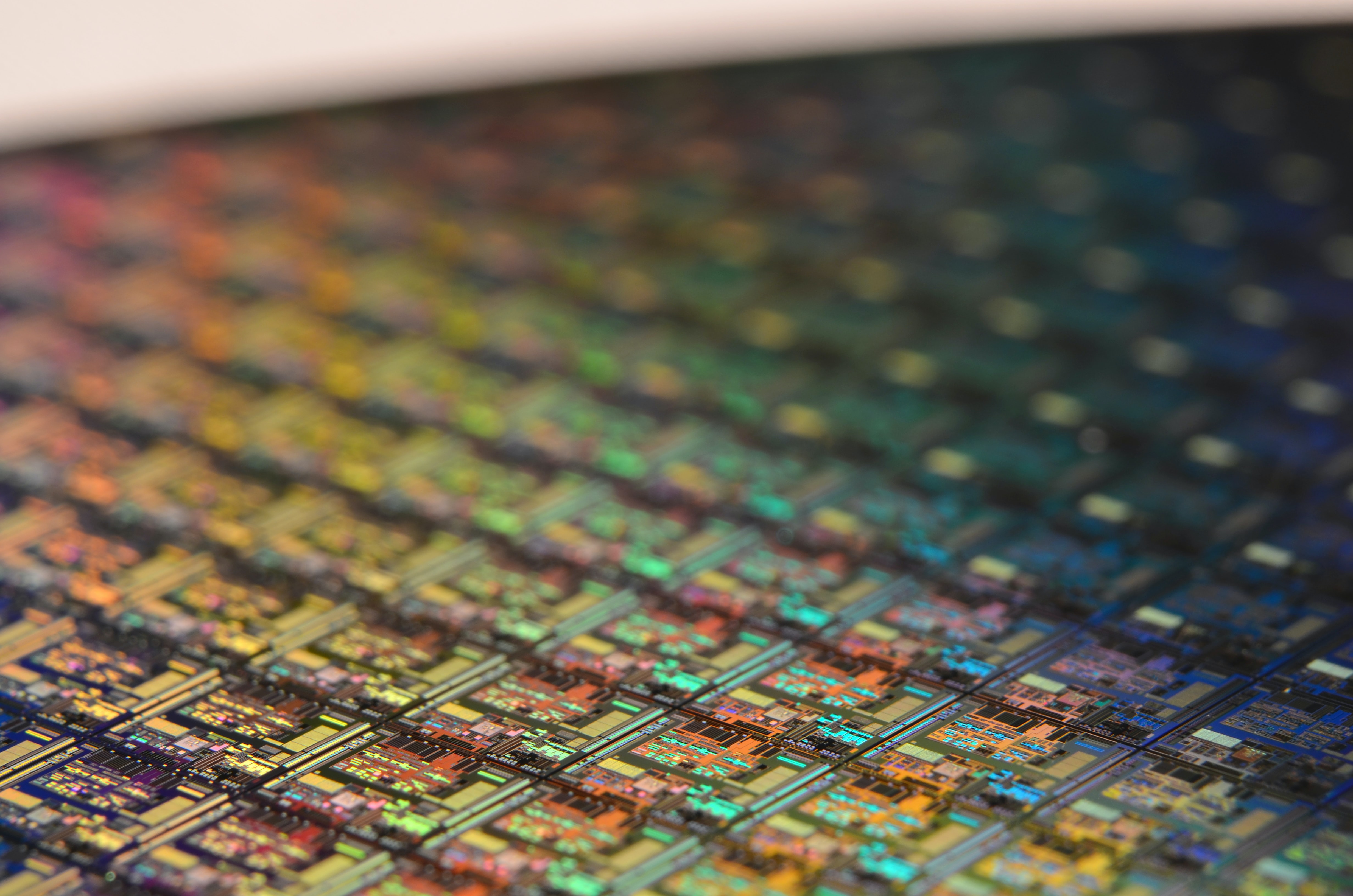
华体会hth登录-全国首个TGV技术产业联盟成立
据“创新松山湖”公众号消息,日前,第二届后摩尔时代玻璃封装基板技术研讨会(2025 TGV+)在东莞松山湖举行。期间,国内首个聚焦玻璃通孔TGV技术的产业联盟揭牌落地,为我国半导体先进封装领域的技术创新与产业协同搭建了重要平台。对于国内企业而言,尽管在玻璃封装基板方面已开展前期探索,技术水平与国际基
2025-10-16 -
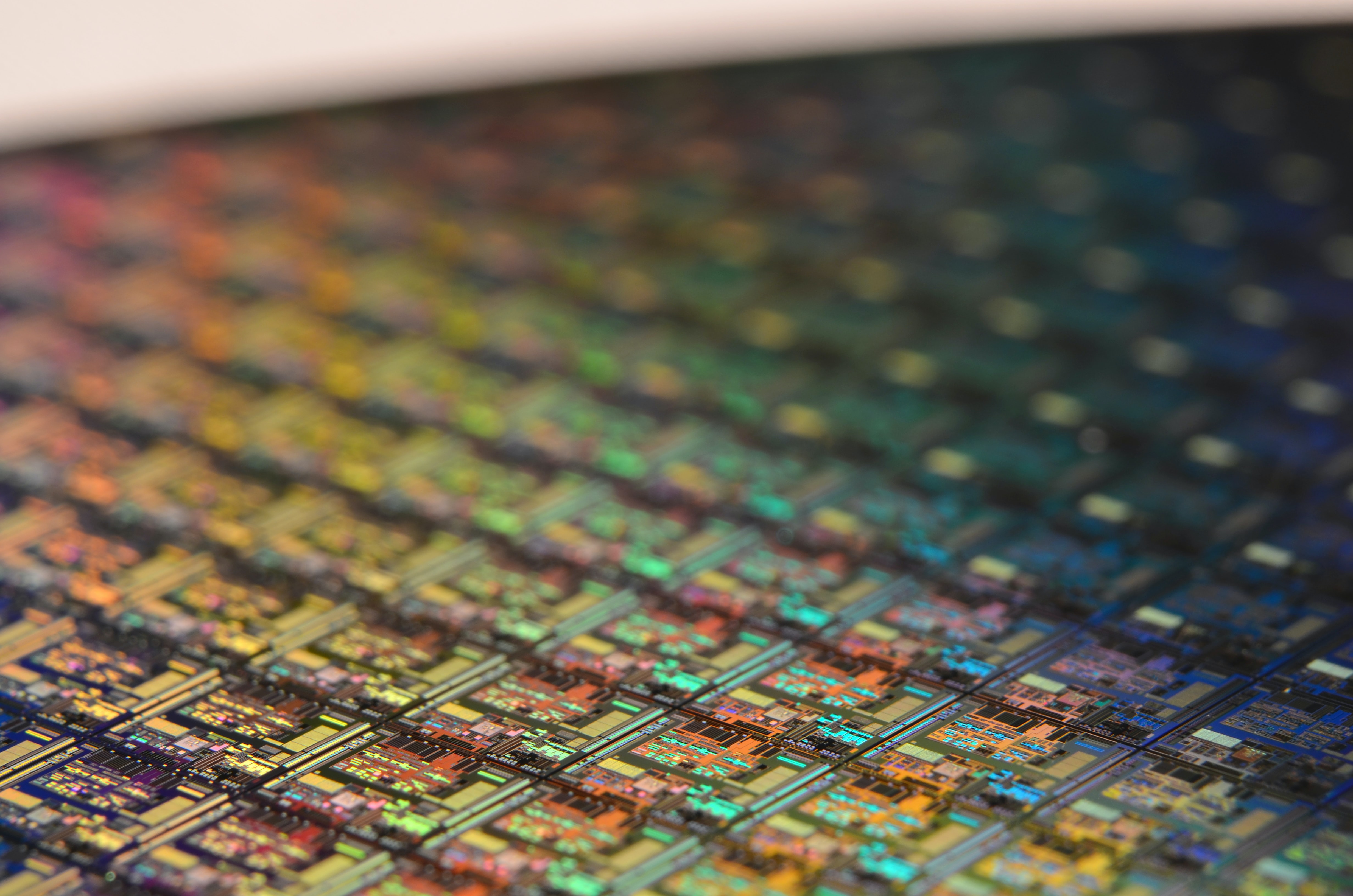
华体会hth登录-ICDIA创芯展将于7月11-12日在苏州召开,近百家本土芯片企业展示新产品新技术新应用
2025ICDIA第五届中国集成电路设计创新大会暨IC应用生态展苏州金鸡湖国际会议中心2025年7月11-12日Part 1大会背景介绍为推动芯片前沿技术突破,展示中国IC创新成果,打造自主可控产业生态,促进本土芯片在人工智能、新能源汽车、物联网、数字经济等领域的大规模应用,“第五届中国集成电路设计
2025-10-16 -
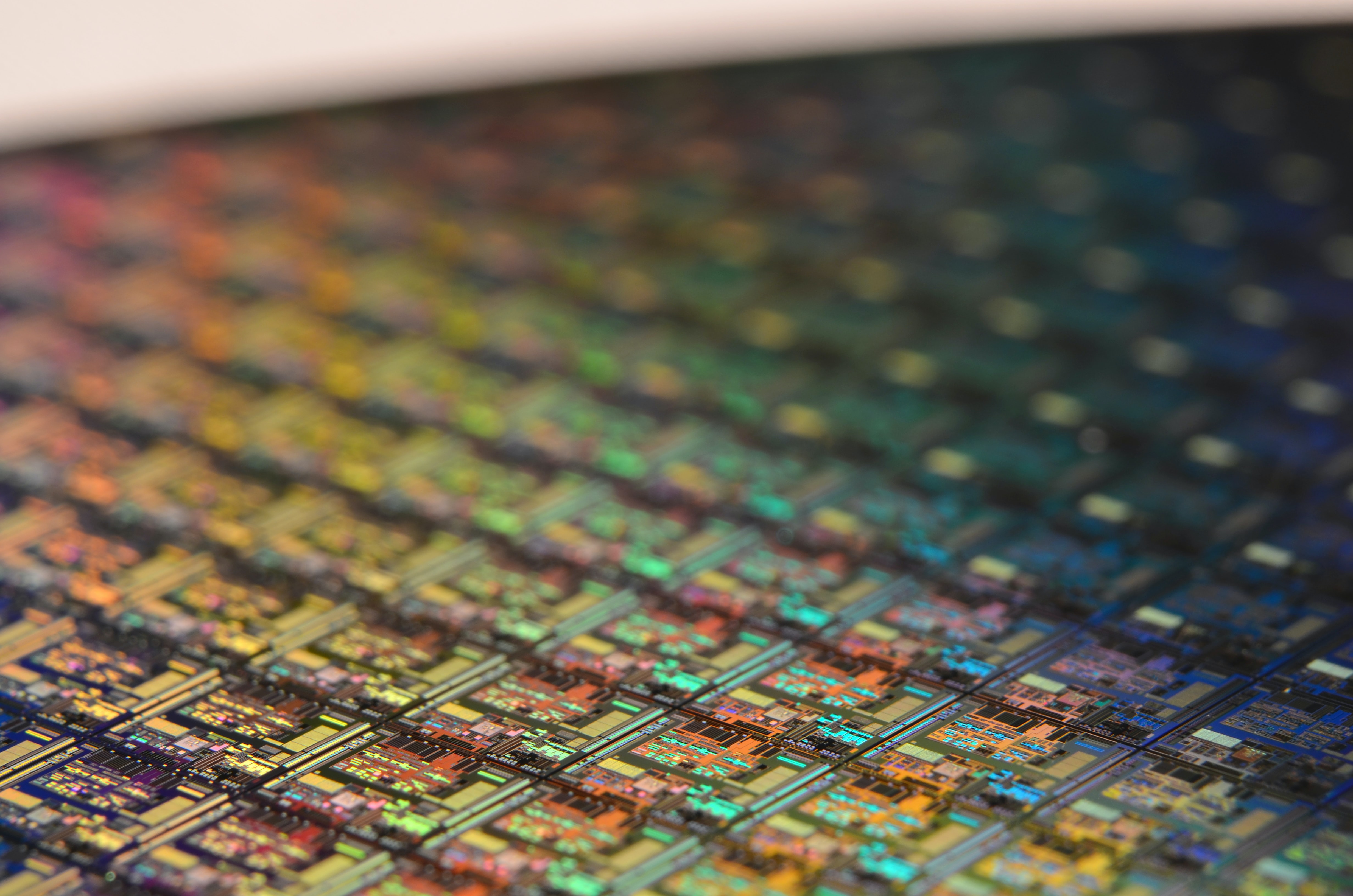
华体会hth登录-德州仪器宣布与英伟达合作,推动 AI 基础设施实现高效配电
TI 技术将助力NVIDIA未来面向下一代AI 数据中心的800V 高压直流配电系统前沿动态德州仪器 (TI) 今日宣布,正与英伟达 (NVIDIA) 合作开发用于数据中心服务器 800V 高压直流 (HVDC) 配电系统的电源管理和传感技术。这一全新电源架构将助力下一代 AI 数据中心更具可扩展性
2025-10-16 -
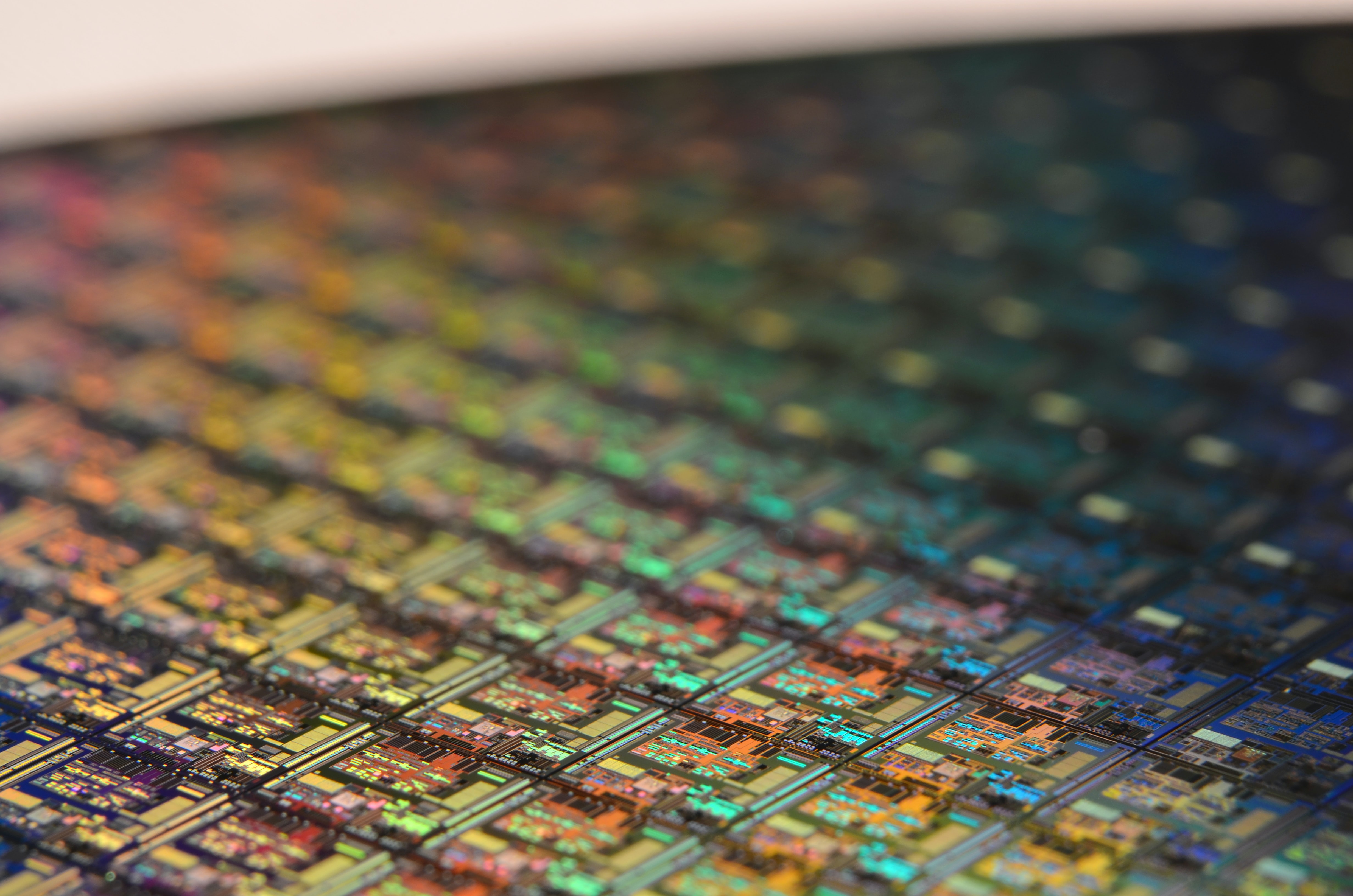
华体会hth登录-灿芯半导体推出28HKC+工艺平台TCAM IP
2025年5月27日,一站式定制芯片及IP供应商——灿芯半导体(上海)股份有限公司(灿芯股份,688691)宣布推出基于28HKC+0.9V/1.8V平台的Ternary Content-Addressable Memory (TCAM) IP。该IP具有高频率和低功耗特性,随着网络设备中快速处理路
2025-10-16








